삼성 '속도전', SK '안정성'…엇갈린 접근법
[서울=뉴스핌] 김정인 기자 = 삼성전자와 SK하이닉스가 차세대 고대역폭메모리(HBM) 성능을 좌우할 핵심 공정으로 '하이브리드 본딩'을 지목하고 조기 안정화에 집중하고 있다. 기술 우위 확보를 위한 경쟁은 연구개발(R&D)과 설비 투자 확대 등 전방위 투자 확대로 이어지고 있다.
◆ 하이브리드 본딩, HBM 경쟁의 핵심 변수로
16일 업계에 따르면 삼성전자와 SK하이닉스는 하이브리드 본딩을 중심으로 HBM 성능 격차를 벌이기 위한 전략을 각각 달리 가져가고 있다.
하이브리드 본딩은 칩을 연결할 때 미세한 돌기(범프)를 사용하는 기존 패키징 방식과 달리 웨이퍼 단위에서 칩을 직접 정밀하게 맞붙이는 공정이다. 이를 통해 적층 두께를 줄이고 신호 전송 거리를 짧게 만들어 데이터 전송 속도와 전력 효율을 크게 향상시킬 수 있다.
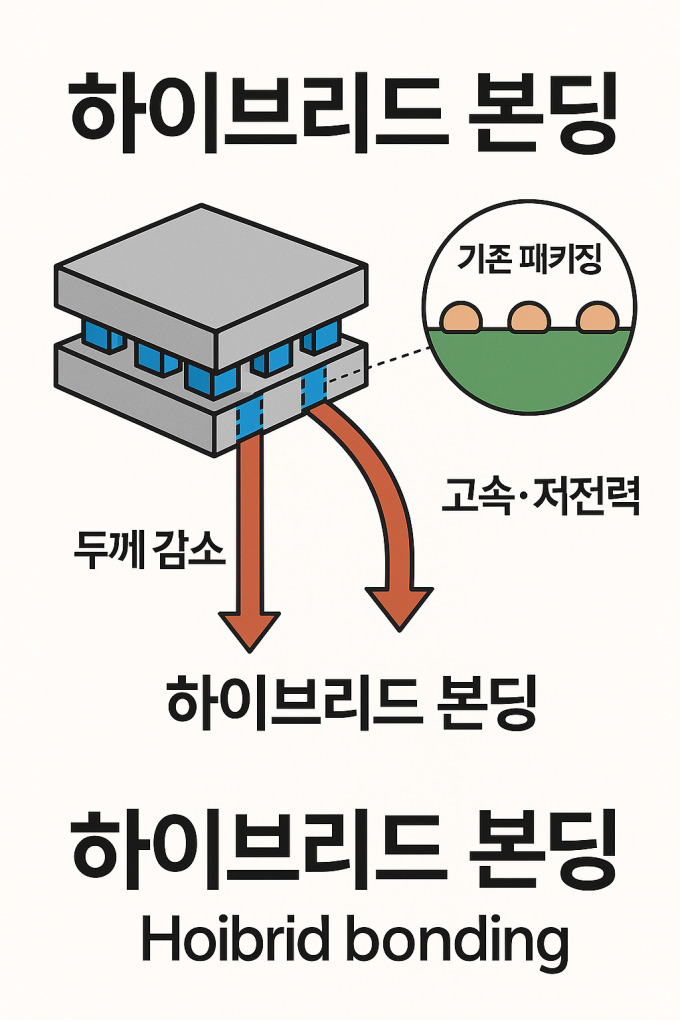
특히 고적층·고대역폭이 요구되는 최신 HBM 제품에서는 신호 손실과 발열 제어가 핵심 변수로 작용하기 때문에 하이브리드 본딩은 기존 공정으로는 구현이 어려운 물리적 한계를 극복할 수 있는 기술로 주목받고 있다. 이에 업계는 하이브리드 본딩의 조기 안정화 여부가 단순한 기술 우위 경쟁을 넘어 수율 확보·패키징 완성도·고객사 대응력 등 복합적 경쟁력을 가를 변수가 될 것으로 보고 있다.
◆ 선제 도입 vs 안정성 중시…전략 엇갈린 삼성·SK
삼성전자는 6세대 HBM(HBM4)에 해당 기술을 선제 도입해 연내 양산에 나선다는 방침이다. 삼성전자는 장비 자회사 세메스와 함께 공정 안정화를 추진 중인 것으로 알려졌다. HBM4를 올해 안에 양산해 HBM3E에서의 열세를 극복하겠다는 전략이다.

SK하이닉스는 기존 공정 안정성을 기반으로 한 보수적 접근을 택했다. 올 하반기 출시 예정인 HBM4에는 기존 'MR-MUF' 공정을 유지하고 하이브리드 본딩은 7세대(HBM4E)부터 도입할 계획이다. 수율과 생산 신뢰성을 우선시한 전략이다.
양사는 특허 확보도 병행하고 있다. 업계에 따르면 삼성전자는 2015년부터 하이브리드 본딩 관련 특허 출원을 시작해 2023년까지 총 83건을 등록했으며, SK하이닉스는 2020년부터 출원을 시작해 같은 기간 동안 총 11건을 공개했다.

양사의 개발 경쟁은 R&D와 시설 투자 지표에서도 확인할 수 있다. 삼성전자의 1분기 사업보고서에 따르면 회사는 올 1분기 R&D에 9조348억원, 시설 투자에 10조9480억원을 집행했다. 전년 동기 대비 각각 15.5%, 13.3% 늘어난 수치로 모두 분기 기준 역대 최대다. SK하이닉스는 같은 기간 R&D 비용 1조5440억원(전년 대비 39.2%↑), 시설 투자 5조8840억원(전년 대비 두 배 이상↑)을 기록했다.
업계 한 관계자는 "하이브리드 본딩 도입 시점과 공정 안정화 속도에 따라 업체 간 경쟁 구도가 달라질 수 있다"며 "공정 성숙도뿐 아니라 수율, 고객사 대응력 등 복합적인 요소가 시장 경쟁력에 영향을 줄 것"이라고 말했다.
kji01@newspim.com























